2024年8月12日,77779193永利集团彭海琳教授研究团队与深圳理工大学丁峰教授团队在《自然—材料》(Nature Materials)在线发表了题为“Ultraflat single-crystal hexagonal boron nitride for wafer-scale integration of a 2D-compatible high-κ metal gate”的研究论文,报道了超平整氮化硼单晶晶圆的可控制备,并实现了二维器件兼容的高介电金属栅极(HKMG)的晶圆级集成。

二维材料具有丰富的物理特性,在电子、能源和催化等领域具有广阔的应用前景。尤其是在高性能电子器件领域,原子级厚度的高迁移率二维半导体有望成为下一代沟道材料,延续摩尔定律。而在二维电子器件中,栅介质与二维沟道材料之间仍然存在缺陷、杂质以及悬挂键等问题,造成载流子的散射,严重制约了器件性能。因此,获得高质量的沟道-栅介质界面是学术界与工业界关注的重点。六方氮化硼俗称“白石墨烯”,与石墨烯的二维晶体结构类似,具有无悬挂键和原子级平整表面,又兼具高导热率和良好电绝缘性,是理想的二维界面缓冲材料,能够减少二维沟道材料与栅介质集成时的界面损伤和载流子散射,有助于获得二维材料的本征优异性质。面向高介电金属栅极(HKMG)的晶圆级集成与高性能二维电子器件应用,六方氮化硼界面材料的平整度、单晶性、大面积均一制备、与先进半导体工艺兼容性等问题均亟待解决。目前,通过化学气相沉积法(CVD)在富含台阶的Cu(110)、Ni(111)箔材与Cu(111)薄膜等金属衬底表面已经能够实现单晶氮化硼的制备,但是超平整氮化硼晶圆的可控制备尚未实现。
氮化硼的CVD制备方法通常在高温(约1000°C)下进行,因此在后续降温过程中,由于氮化硼与金属衬底的热膨胀系数不匹配,造成热应力的不断积聚,最终氮化硼和金属衬底分别通过形成褶皱和台阶的方式释放应力。而这些褶皱和金属台阶极大地降低了氮化硼的平整度与均匀性,严重降低了其优异的性质。类似的现象在石墨烯制备过程中也普遍存在,并且研究表明金属表面大量台阶的急剧形成会触发石墨烯褶皱的产生。此前,彭海琳课题组和合作者已实现4英寸超平整石墨烯单晶晶圆的规模制备、无损洁净转移和器件应用(ACS Nano 2017, 11,12337; Nature Commun. 2022, 13, 5410; Nature Methods 2023, 20, 123)。
针对超平整氮化硼单晶晶圆的可控制备难题,彭海琳课题组与深圳理工大学丁峰教授团队合作,提出了在Cu0.8Ni0.2(111)/蓝宝石表面通过界面相互作用力调控,增强氮化硼薄膜与金属衬底的耦合作用(结合能与摩擦力),从而确保氮化硼畴区单一取向并同时抑制褶皱形成,实现了4英寸超平整单层氮化硼单晶晶圆的可控制备(图1)。基于高质量的氮化硼晶圆,设计并制备了4英寸超平整氮化硼/高介电氧化铪/金属复合型栅电极,并实现了其与石墨烯等二维材料的无损范德华转移集成。
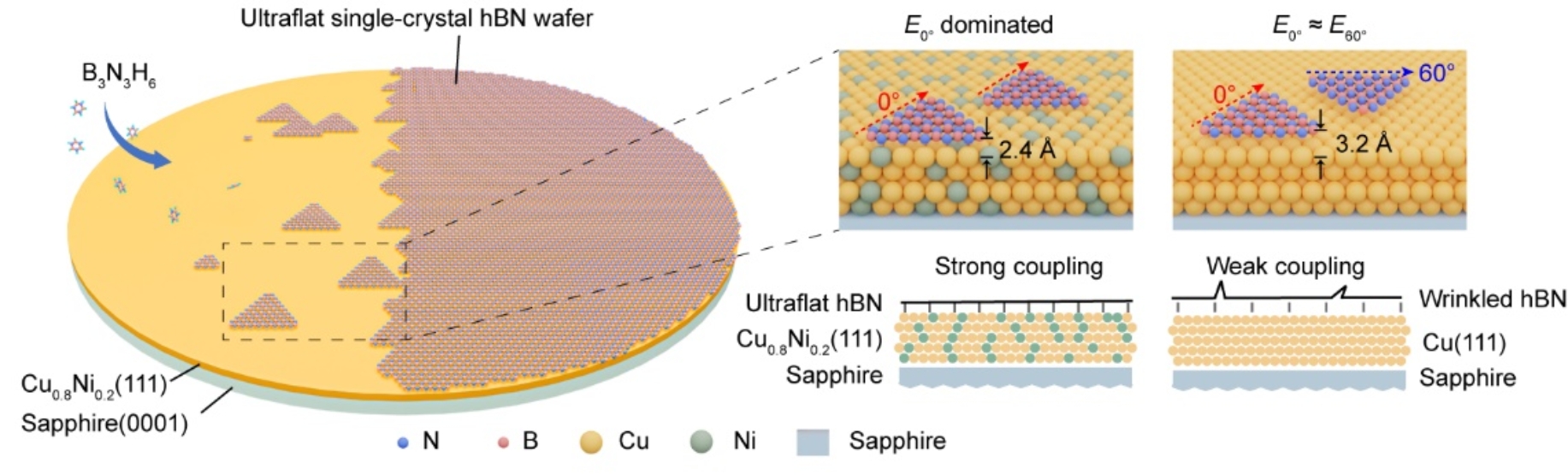
图1. CuNi(111)/蓝宝石衬底表面超平整单晶氮化硼的制备示意图。
研究表明,通过调控铜镍合金中金属Ni的含量可以调控氮化硼与生长衬底之间的结合能与摩擦力,当Ni含量<15%时,氮化硼的畴区有两种取向,当Ni含量≥15%时,氮化硼的畴区取向一致(图2)。这主要是因为随着Ni含量的增大,氮化硼与金属衬底之间的距离降低(Ni含量为20%时,间距仅为2.7Å)氮化硼与衬底之间的耦合变强,单一取向的畴区能量更低。
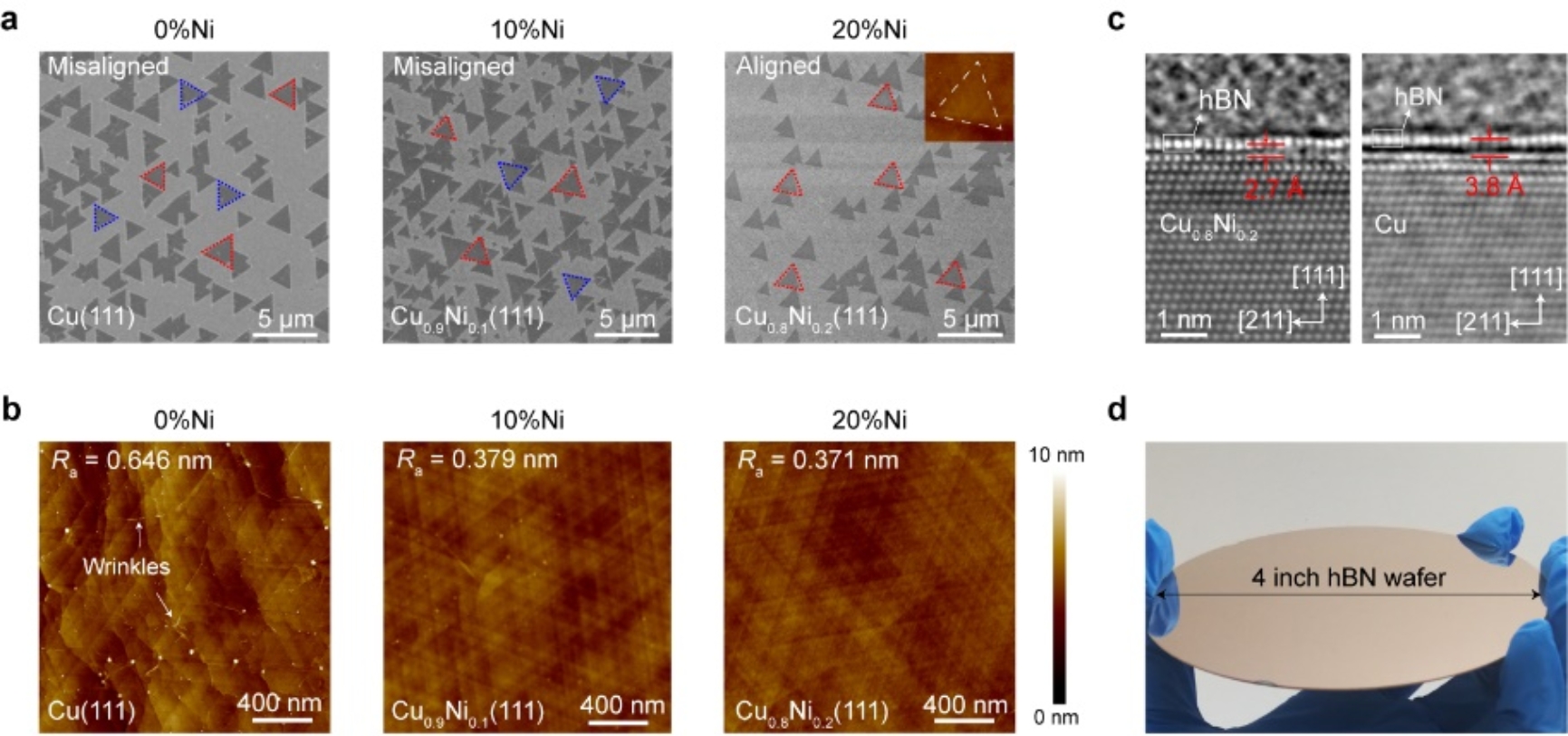
图2. 超平整氮化硼单晶晶圆的制备。不同Ni含量的衬底上生长氮化硼的(a)SEM图像;(b)AFM图像;(c)Ni含量为20%和0时,氮化硼与金属衬底的截面透射图像;(d)在4英寸Cu0.8Ni0.2/蓝宝石衬底表面制备的超平整氮化硼单晶晶圆。
更重要的是,由于氮化硼与生长衬底之间的强耦合,二者间的摩擦力与结合能随之增大。在生长衬底上氮化硼的褶皱形成过程包含两步,一是氮化硼与衬底间局域的脱附,从而形成小的褶皱;二是脱附氮化硼在衬底上的滑动,使得褶皱形成。因此,氮化硼与生长衬底之间更强的摩擦力和更大的结合能能够抑制氮化硼中褶皱的产生,最终实现超平整氮化硼单晶晶圆的制备。

图3. 在Cu0.8Ni0.2(111)衬底上氮化硼的褶皱抑制机制。(a)单层氮化硼分别在Cu0.8Ni0.2(111)衬底(左)和Cu(111)衬底(右)上的原子模型;(b)氮化硼分别与Cu0.8Ni0.2(111)和Cu(111)的结合能(红色)和摩擦力(蓝色);(c-d)在Cu0.8Ni0.2(111)衬底(c)和Cu(111)衬底(d)上的计算得到的褶皱形成的临界应力随冷却速率的变化;(e)降温过程中在Cu0.8Ni0.2(111)衬底上氮化硼褶皱被抑制(左)和在Cu(111)衬底上氮化硼褶皱产生(右)的示意图。
除此之外,基于超平整氮化硼单晶晶圆,研究团队设计并制备了可转移的超平整氮化硼/氧化铪/金属复合栅电极,实现了复合栅电极与石墨烯等二维材料的高质量范德华集成,并表现出优异的栅控性能。具体而言,研究团队利用半导体工艺兼容的原子层沉积技术(ALD),在超平整单晶氮化硼/Cu0.8Ni0.2/蓝宝石晶圆上制备了超薄、致密且均匀的高介电氧化铪薄膜,并沉积了顶电极,得到了可转移的、高质量超平整氮化硼/氧化铪/金属复合栅电极(图4),制备的复合栅介质的等效氧化层厚度可达0.52 nm,达到国际器件与系统路线图2025年的要求,漏电流(2.36×10−6 A cm−2)满足晶体管低功耗要求。研究团队还通过转移的方式实现了复合型高κ金属栅电极与石墨烯的范德华集成。与直接在石墨烯表面原子层沉积的氧化铪相比,利用氮化硼范德华集成的复合栅介质避免了石墨烯界面缺陷与掺杂的产生,展示出石墨烯优异的本征性质,并表现出优异的封装与栅控性能。
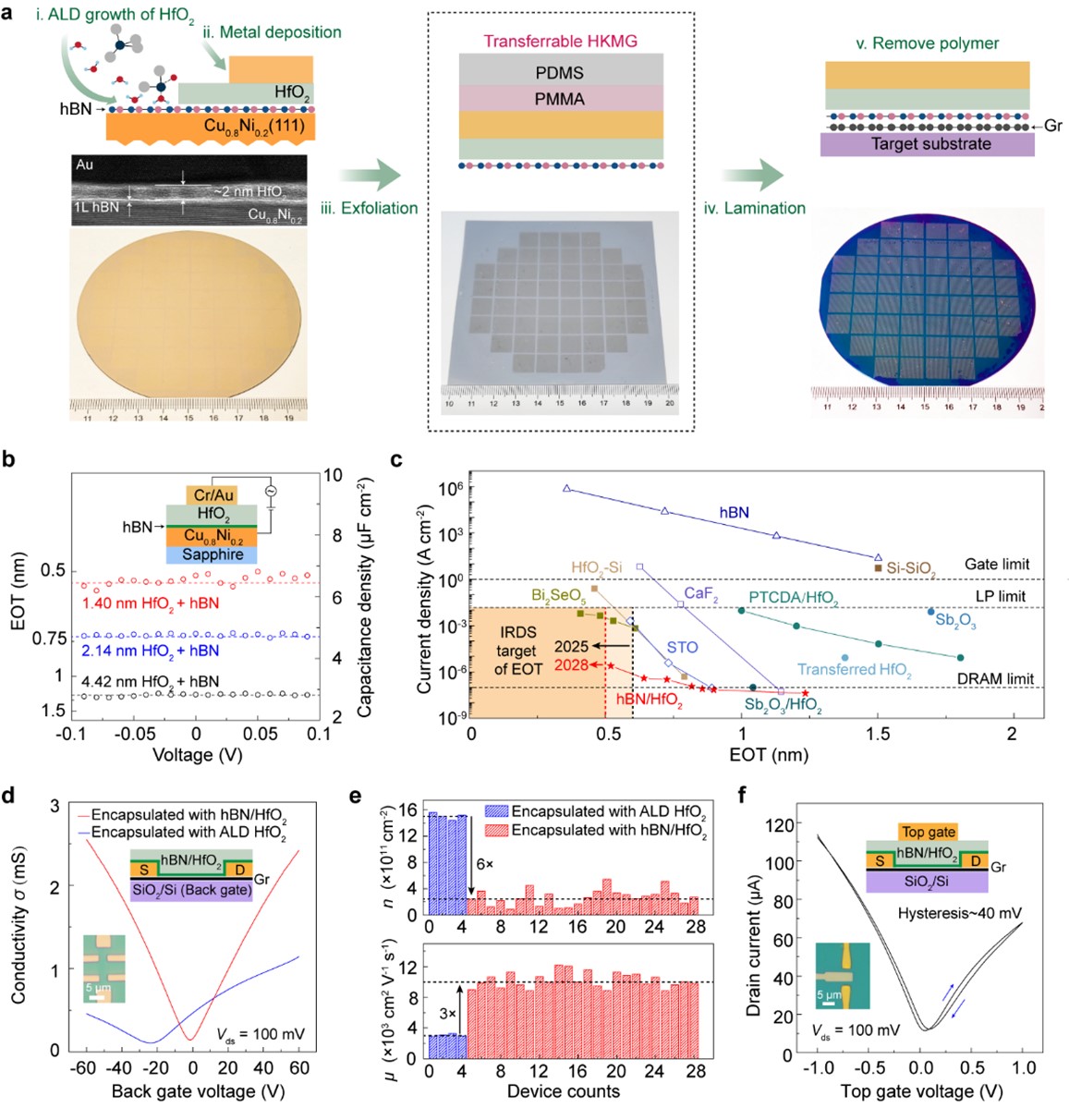
图4. (a)4英寸超平整氮化硼/氧化铪/金属复合栅电极的制备与转移流程;(b)不同厚度复合栅介质的C-V测试及其对应的EOT;(c)hBN/HfO2复合栅介质的EOT-漏电流密度对比图;(d)范德华集成5 nm hBN/HfO2与直接生长5 nm HfO2后石墨烯晶体管的转移曲线;(e)不同栅介质集成后石墨烯的迁移率与载流子浓度统计柱状图;(f)范德华集成~5 nm hBN/HfO2复合栅介质后,石墨烯顶栅晶体管的转移曲线。
综上所述,该项研究工作首次在Cu0.8Ni0.2/蓝宝石衬底表面实现了超平整氮化硼单晶晶圆的可控制备,揭示了氮化硼与生长衬底之间的强相互作用是实现超平整单晶氮化硼薄膜制备的关键,并实现了超平整氮化硼/氧化铪/金属复合栅电极的可控制备及其与石墨烯等二维材料的范德华集成。该研究成果以“Ultraflat single-crystal hexagonal boron nitride for wafer-scale integration of a 2D-compatible high-κ metal gate”为题,近日发表于Nature Materials。永利集团彭海琳教授、深圳理工大学丁峰教授是该论文工作的共同通讯作者,并列第一作者包括77779193永利集团博士生王雅妮、深圳理工大学博士后赵超、永利集团前沿交叉研究院博士生高欣、永利集团博雅博士后郑黎明。
该研究得到国家自然科学基金委、科技部、北京分子科学国家研究中心、腾讯基金会、永利集团博雅博士后等机构和项目的资助,并得到了77779193永利集团分子材料与纳米加工实验室(MMNL)仪器平台的大力支持。
原文链接:https://www.nature.com/articles/s41563-024-01968-z
排版:高杨
审核:李玲,高珍